Advantages
- プローブに印加する交流バイアス電圧を高周波(500 kHz超)にした高機能なKPFM。
- 物質表面や界面の準位密度を「精確に」測定することを可能に。例えば、半導体ヘテロ接合界面での界面準位密度を、いわゆるバンドベンディングの影響なしに測定できる。
- ワイドギャップ半導体、高誘電率ゲート絶縁膜、グラフェンや電池電極など様々な物質の表面状態の精緻な評価を可能にし、新規素材やデバイスの開発をアシストする測定技術。
Background and Technology
半導体素子の開発や製造における接合界面の形状・性状観察や製品検査、あるいは太陽電池や燃料電池、リチウムイオン電池などの開発における電極表面状態の性質評価など、素子の極小化や高性能化に伴い界面状態の精緻な測定手法が求められている。しかし従来の界面準位密度を測定する顕微鏡(Conductive AFM)では、計測感度や空間的・時間的分解能が低い、装置中の静電容量センサの浮遊容量による影響が生じるなどの問題があった。
大阪大学工学研究科の菅原康弘教授らはこれまでに、KPFM(ケルビンプローブフォース顕微鏡)における接触電位の読み取り時間分解能を、印加する交流バイアス電圧を高周波にすることで、最大1000倍高速化する技術を開発していた。このたび、さらに技術を発展させ、高周波印加と低周波印加を切り替えることで、プローブと被測定物との間に生じる静電気相互作用を測定することにより、被測定物表面の準位密度をナノメートルスケールで測定することを可能にした(図参照)。 従来技術は低周波印加のみだったため、測定した情報には半導体のバルクの情報と表面のバンド曲がりの情報が混じっていたが、高周波印加によって半導体のバルクの情報のみを読み取ることができる。つまり、半導体などの界面に関するより精緻で精確な情報を観察することが可能となった。菅原先生らはこのKPFMを作成し、イオン注入されたシリコンの表面における、異なる周波数の交流バイアス電圧印可時の静電気力の変化を測定し、界面準位密度を観察することに成功している(論文参照)。
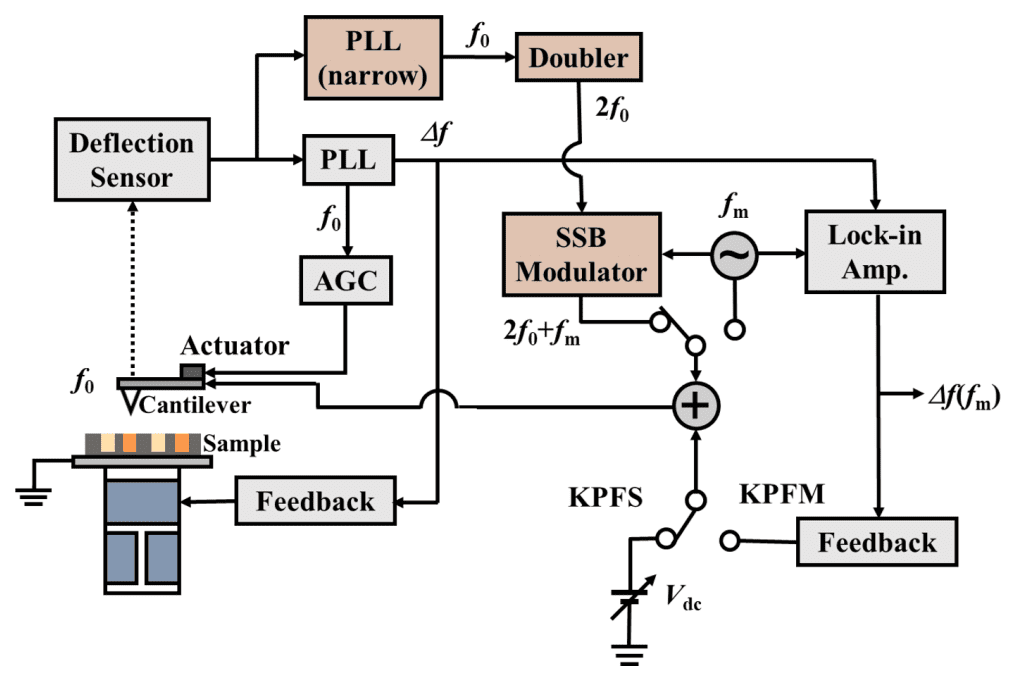
図 1 本技術のKPFMの回路構成。図中中央右にある切替部で、高周波(2f0+fm)と低周波(fm)を切り替える。(菅原先生ら論文から引用)
Expectations
大阪大学では本技術を用いた顕微鏡装置を開発するパートナー企業を募集する。また、半導体製造や電池電極製造などで界面準位密度の測定ニーズを持つ企業との共同研究も歓迎する。
Publication
・Beilstein J. Nanotechnol. 2023, 14, 175-189 にて原理と実験結果を報告。
Patent
・特許出願中
Researchers
菅原 康弘(大阪大学 工学研究科 教授)
以下のフォームからお問い合わせください

